氧化硅内嵌铜柱晶圆研磨抛光解决方案
客户样品初始状态:
材料:硅基表面复杂结构(氧化硅内嵌铜及面覆铜);尺寸:100mm*100mm;形状:方形;厚度:600um;粗糙度:铜与氧化硅表面大马士革形貌;TTV:3um
加工后指标要求:
化学机械抛光,氧化硅粗糙度Ra≤0.5nm,铜粗糙度Ra≤1.5nm,抛光后TTV≤3um,铜与氧化硅层厚差≤20nm
工艺解析:
Step1覆铜面抛阶段:使用我司CDP系列化学机械抛光设备,配备订制抛头吸附装置,抛头面压1.5-3.2Psi,抛头转速60–90 rpm,抛光盘转速80-110rpm,以A21专用抛光液为抛光浆料进行化学机械抛光
Step2复合结构抛光阶段:以Step1为基础,更换Z4U抛光液为抛光浆料,最终达到氧化硅层与铜层的同步抛光
案例配套主机与耗材:CDP系列化学机械抛光设备,订制抛光吸附装置,聚氨酯硬质抛光垫
客户反馈:解决了氧化硅与铜之间的层厚差问题,高于原始诉求指标。

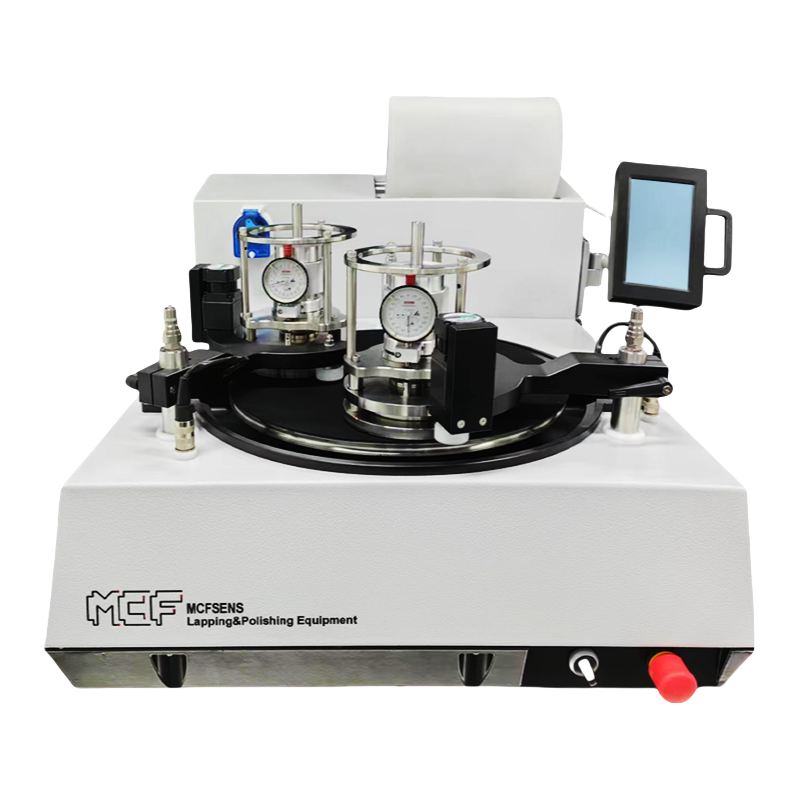
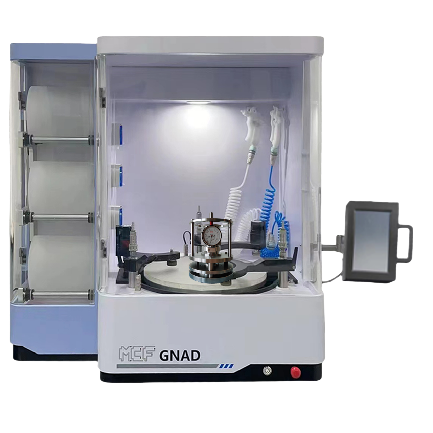


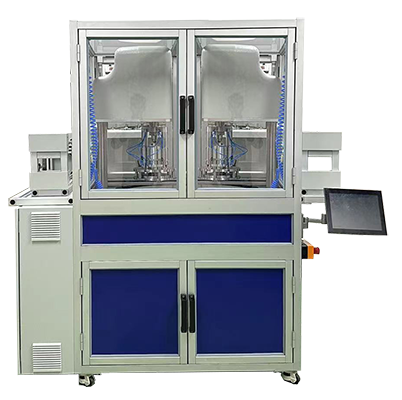

























 400-6988-696
400-6988-696 预约咨询
预约咨询