在半导体制造迈向3nm制程的进程中,研磨抛光机搭载的CMP(化学机械抛光)技术,成为实现晶圆全局平坦化的终极解决方案。
针对硅片、覆铜硅基以及金半混合表面在多层堆叠中产生的微米级起伏,高精度CMP设备通过纳米磨料配方与分区加压的协同作用,将表面粗糙度精准控制在0.1nm以内。在5G射频芯片制造中,其独创的铜/钽双材料同步抛光工艺突破界面高度差难题,使覆铜层厚度偏差≤5Å;而在三维封装领域,智能终点检测系统可自动识别10nm级金属互连层差异,消除介质凹陷缺陷。
该技术使28nm以上晶圆平坦化良率达99.98%,推动半导体行业突破“摩尔定律”极限,成为先进制程不可或缺的基石工艺。

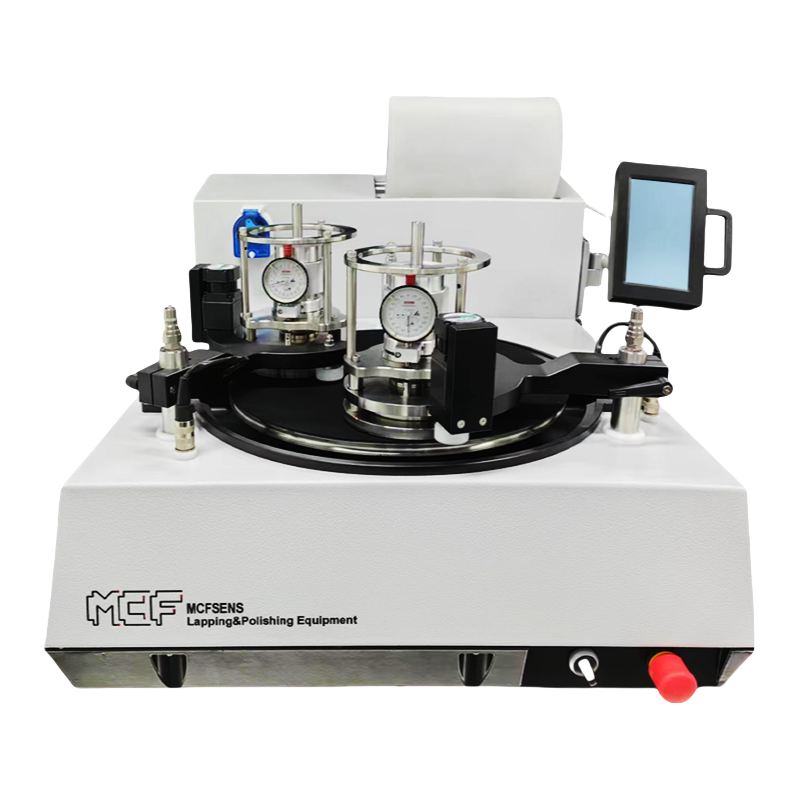
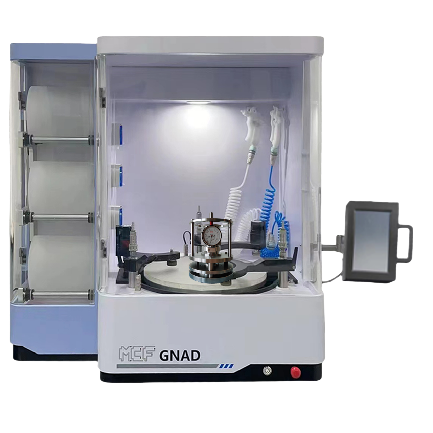


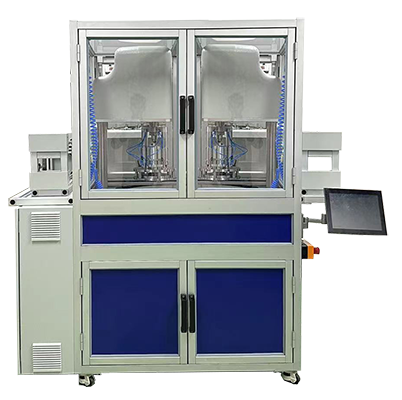























 400-6988-696
400-6988-696 预约咨询
预约咨询